Анализ инноваций в технологии упаковки на уровне пластин
2024/7/25 17:54:17
Вид:
Области применения упаковки на уровне пластин
Упаковка на уровне пластин широко используется в различных областях, включая мобильные коммуникации, потребительскую электронику, автомобильную электронику и медицинские устройства. Она широко применяется в таких продуктах, как мобильные телефоны, планшеты, камеры и датчики, обеспечивая этим устройствам более высокую производительность и меньший размер.
Процесс упаковки на уровне пластин
1. Уменьшение пластины: Пластина точно уменьшается с использованием передовых технологий до требуемой толщины для удовлетворения последующих требований упаковки.
2. Металлизация задней поверхности: Слой металла наносится на заднюю поверхность пластины для эффективного соединения микросхемы с подложкой упаковки, улучшая проводимость и тепловые характеристики.
3. Внедрение медных/оловянных шариков: Медные шарики или припойные шарики внедряются в микросхему для обеспечения надежного соединения между микросхемой и подложкой, оптимизируя электрическую производительность.
4. Формовочная упаковка: Формы используются для плотной упаковки микросхемы и подложки упаковки вместе, образуя прочную и компактную структуру упаковки для защиты внутренней микросхемы.
5. Тестирование после упаковки: Упакованная микросхема проходит тщательное тестирование, чтобы убедиться, что она соответствует установленным стандартам по производительности и качеству, обеспечивая надежность продукта.
Преимущества упаковки на уровне пластин
1. Экономически эффективная: Технология упаковки на уровне пластин уменьшает использование упаковочных материалов и отходов в процессе, значительно снижая затраты на упаковку. Кроме того, она упрощает последующие процессы тестирования и сборки, что позволяет сэкономить на производственных затратах.
2. Компактная упаковка: Упаковка на уровне пластин непосредственно упаковывает всю микросхему на пластине, в результате чего размер упаковки уменьшается. Этот компактный дизайн идеально подходит для приложений, требующих миниатюризации и легкости, таких как мобильные устройства и носимые устройства.
Виды упаковки на уровне пластин
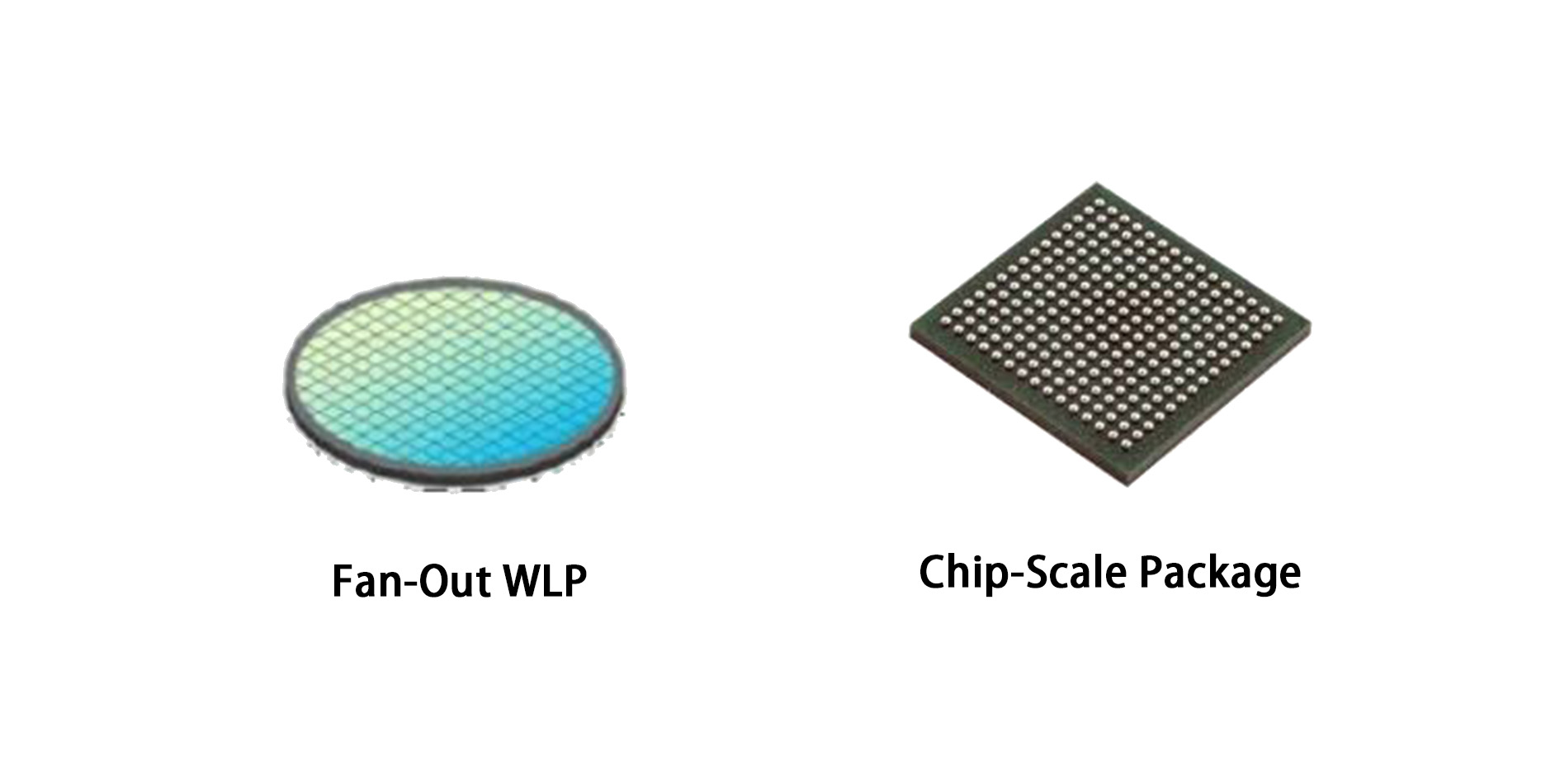
Упаковка на уровне пластин и уровне чипов
1. Упаковка на уровне пластин с расширением (Fan-Out WLP): Этот процесс расширяет подложку упаковки вокруг пластины с помощью специальных форм, делая упаковку микросхемы более компактной. Она чрезвычайно подходит для приложений, требующих высокой интеграции, значительно улучшая плотность и производительность упаковки.
2. Упаковка на уровне чипов (CSP): Упаковка на уровне чипов является высоко компактной технологией упаковки, размер которой почти совпадает с самим чипом. Поскольку обычно не требуется соединение проводов, эта форма упаковки не только значительно снижает затраты на упаковку, но и экономит пространство, что выгодно для приложений, требующих миниатюризации и высокой эффективности.
Упаковка на уровне пластин представляет собой передовую технологию упаковки микросхем, которая непосредственно упаковывает микросхему в процессе производства пластины. По сравнению с традиционными технологиями упаковки, упаковка на уровне пластин значительно сокращает дополнительные этапы упаковки, повышает производственную эффективность и увеличивает плотность упаковки, что приводит к более компактной структуре упаковки.





